次世代のHigh-kマスク(高吸収体マスク)は、高NA EUVリソグラフィにおいて不可欠な技術です。
従来のEUVマスクは、多層膜(Mo/Si)の上にタンタル(Ta)ベースの吸収体で回路パターンを描いていましたが、微細化が進むにつれて「マスク3D効果」という光学的な問題が深刻化しています。High-kマスクは、これを解決するために開発されています。
1. なぜHigh-kマスクが必要なのか?
微細化が進み、光の波長(13.5nm)に近いサイズのパターンを露光するようになると、以下の課題が発生します。
-
マスク3D効果 (M3D Effects): 吸収体(パターン)に厚みがあるため、光が斜めに入射した際に「影」ができたり、位相がずれたりして、ウェハ上での解像度が低下します。
-
高NA化による入射角の増大: 高NA装置ではレンズの角度が大きくなるため、マスクへの入射角も鋭くなり、影の影響がさらに顕著になります。
2. High-k(高吸収)素材の役割
従来のタンタル(Ta)よりもEUV光の吸収率が高い(消衰係数 k が大きい)素材を使用することで、以下のメリットが得られます。
-
薄膜化: 吸収効率が高いため、従来(約60nm〜70nm)よりも大幅に薄い膜(約30nm〜45nm以下)で光を遮断できます。
-
影の低減: 膜が薄くなることで、斜め入射による影の影響が減り、微細なパターンの忠実度が向上します。
-
コントラストの向上: 迷光が減り、像のコントラスト(NILS: Normalized Image Log Slope)が改善されます。
3. 主要な候補材料と課題
2026年現在、実用化に向けて以下の材料が研究・採用されています。
| 材料 | 特徴 | 課題 |
| ルテニウム (Ru) 合金 | 吸収率が高く、比較的加工しやすい。 | マスク洗浄時の耐久性。 |
| 白金 (Pt) / タングステン (W) 合金 | 非常に高い吸収性能を持ち、M3D効果を最小化できる。 | エッチング(削り出し)が困難で、微細加工に高度な技術が必要。 |
| ニッケル (Ni) / コバルト (Co) | 高い吸収率を持つ金属。 | プロセス適合性と安定性。 |
4. 業界の進展
-
ASML / imec: ベルギーの研究機関imecとASMLの共同ラボにおいて、高NA EUV装置(EXE:5200)とHigh-kマスクを組み合わせたプロセス開発が加速しています(2026年Q4には完全なクオリフィケーションを予定)。
-
マスクメーカー: HOYAやDNP(大日本印刷)などが、次世代のHigh-kブランクス(マスクの基材)や描画技術の開発で世界をリードしています。
補足:フェーズシフトマスクとの組み合わせ
High-k素材は、単に光を遮るだけでなく、光の位相を180度反転させて解像度を高める「アテニュエーテッド位相反転マスク(att-PSM)」としての活用も期待されています。これにより、さらなる微細化(1nm世代以降)への道が拓かれます。
RFSoCでの信号処理やGHz帯の評価など、実務レベルの計測をされている観点からすると、このマスク技術は「信号のS/N比を物理的な光学系でいかに稼ぐか」という、通信のインテグリティ改善に近いアプローチと言えるかもしれません。
出典:Google Gemini (Gemini は AI であり、間違えることがあります。)
SMM3000Xシリーズ 高精度ソースメジャーユニット・表示桁数:6½桁(2,100,000カウント) ・SMM3311X(1ch) / SMM3312X(2ch) ・価格:90万円~ |
|
|
・USB VNA |
・Coming soon |
 |
SDS8000Aシリーズ オシロスコープ 特長と利点 ・Coming soon |
 |
SSG6M80Aシリーズ ・Coming soon
|
 |
 |
 |
SSA6000A Series Signal Analyzer Main Features ・Coming soon
|
 |
SNA6000A Series Vector Network Analyzer Key Features
|
お礼、
T&Mコーポレーションは設立5年ですが、おかげさまで業績を着実に伸ばしており、
オフィスを港区芝(最寄り駅浜松町)に移転し、スペースも拡大いたしました。
電子計測器業界の「ゲームチェンジャー」として、高性能/高信頼/低価格/短納期を武器に
T&Mコーポレーションはお客様のご予算を最大限生かす製品群をご提案させていただいております。




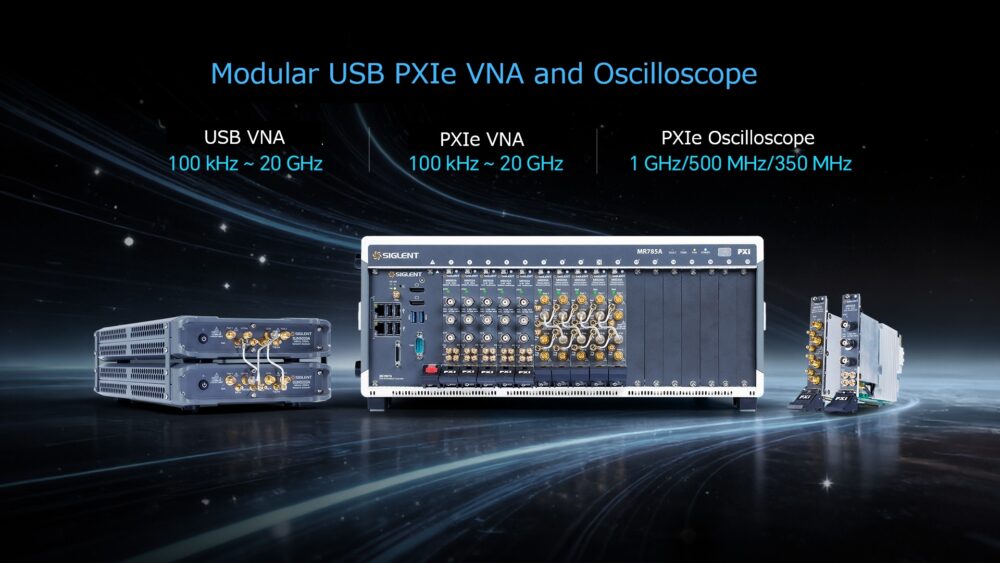











 T&M
即納ストア
T&M
即納ストア